超高去除速率铜CMP研磨剂的开发 - 材料技术 -
高密度IC器件涉及互连的多层堆叠。化学机械平坦化(CMP)工艺为光刻需求提供了晶圆上的平滑表面,已成为半导体制造中获得高良率的关键工艺。当半导体工业向45nm及更小节点前进时,集成方案正面临着平衡互连特征尺寸缩小和互连材料物理性质极限的挑战。硅通孔(TSV)以穿过晶圆的互连结构堆叠芯片构造,能减少焦耳热效应和芯片所占面积,同时增加互连密度。它可以增加输入-输出点数,并使芯片实际成本降到最低。
TSV是穿过晶圆总厚度垂直形成的导电路径,这能降低互连路径的复杂性并可使封装中有更多的输入-输出通道。TSV制作中采用铜作为互连材料。在这种Cu 3D TSV工艺中,通孔被铜填充,同时也在晶圆上淀积了一层厚的不均匀铜层。覆盖的铜层厚度为3-20μm,需用CMP除去,只留下通孔中的Cu,建立贯穿晶圆的互连(图1)。除去这种厚Cu层要求优化Cu CMP工艺。主要的要求之一是超高速Cu CMP工艺,以获得合理的工艺时间和产额。
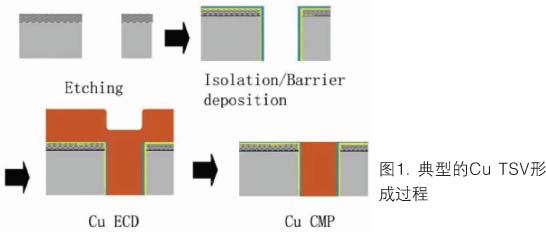
一般来说,Cu CMP 研磨剂含有磨料粒子、氧化剂、腐蚀抑制剂和pH调节剂。为了得到某种性能,有时还加入络合剂、表面活性剂、流变调节成分和其它特殊成分。CMP要求去除速率、平坦化和表面质量间的平衡。为了达到这一平衡,将腐蚀抑制剂引入配方中。其作用是钝化表面,使氧化速率得到控制,防止表面凹坑和刻蚀。Cu去除速率取决于表面氧化速率、钝化速率、刻蚀速率、Cu消失速率和磨料粒子对钝化膜的抛光效率。Cu的高去除速率可能引起表面高腐蚀、高缺陷率和表面形貌控制差。开发3D TSV Cu CMP研磨剂的真正挑战是如何达到超高Cu去除速率,而又有好的平坦化、表面形貌、缺陷率和表面粗糙度。
本文阐述了用于3D的研磨剂的开发情况。基于Planar公司的CSL-904X Cu研磨剂平台,开发了新的高去除速率Cu研磨剂。为了进一步改进,开发了超高去除速率研磨剂ER9212,用于Cu 3D TSV的目标去除速率为4~5μm/min。它也可用于Cu MEMS工艺中。
查看评论 回复









