aveni S.A. 运用创新电镀化学,将铜互连扩展至5nm及以下节点以实
为2D互连和3D硅穿孔封装提供颠覆性湿沉积技术与化学材料的开发商与生产商aveni S.A.今日宣布,其已获得成果可有力支持在先进互连的后段制程中,在5nm及以下技术节点可继续使用铜。
「值此铜集成20周年之际,我们的研究结果证实了IBM研究员Dan Edelstein在近期IEEE Nanotechnology Symposium上的主题演讲中所表达的意见:『铜集成可持续使用』。」aveni执行长Bruno Morel指出。
由于器件要满足(和创造)市场需求,因而不可避免地不断缩小尺寸,设计师们正不断努力开发替代集成方案,不仅包括前段制程的方案还有后段制程(BEOL)的方案。其中,最突出的是,替换双嵌入式互连中的铜线,以弥补因较细的铜联机而产生对器件速度有负面影响的电阻电容延迟。建议的替代方案为用钴代替铜,可能性最大的候选材料或较为特殊的材料有纳米钌管、纳米石墨烯管或纳米碳管。
先进双嵌入式结构采用原子层沉积氮化钽(TaN)铜扩散阻挡层, 这是一种薄化学气相沉积(CVD)钴衬料,和布线为其主要构成物的电镀铜填充层。早代产品(≥7nm节点)也在钴填孔和铜填孔间采用了物理气相沉积(PVD)铜晶种层,但先进器件由于边际晶种覆盖和集成障碍问题逐渐淘汰了这种膜层。
特别重要的一点是,薄TaN阻隔层避免了铜的扩散和器件的损坏。(TaN上的)薄钴衬料的完整性对确保屏蔽功能正常十分关键。应用于5nm技术节点的钴衬料的厚度减少至接近于3nm,降低了传统电镀铜制程的灵活性。
在最近的研究中,aveni将其Sao?碱性电镀铜化学性能与传统的商用酸性镀铜的性能进行了比较。电镀样品为TaN上3nm CVD钴。研究结果显示,酸性铜化学材料腐蚀了钴填料,导致电镀化学物质与底层的TaN层发生反应并形成氧化钽(TaOx)。TaOx的形成是导致器件故障的另一种表现形式,因为它导致了断路,妨碍了电流流动。
采用aveni的Sao化学材料的钴依然保持完整,也没有形成TaOx,这使铜互连延伸到5nm及以下的技术节点。
aveni首席技术官Frédéric Raynal评价说:「我们很兴奋能获得这些研究结果,因为它们证实了我们对电镀铜Sao碱性化学材料优于酸性化学材料的定位,尤其是在先进节点中薄钴衬料技术的运用。」
aveni将于2018年初公布完整调查报告。
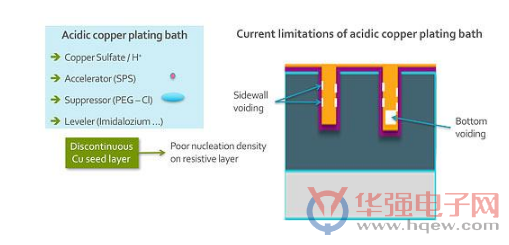
查看评论 回复
"aveni S.A. 运用创新电镀化学,将铜互连扩展至5nm及以下节点以实"的相关文章
热门文章
- 我国提交PCT国际专利申请量跃居全球第二-embedcc资讯-
- GaN Systems公司与罗姆联手致力于GaN功率器件的普及-e
- TI为智能音箱和回音壁提供优质音效与综合保护-embedcc
- ADI公司针对下一代射频、微波和毫米波应用 推出行业最
- 以高集成度为核心:新型MSP430微控制器 为感测应用提
- Molex发布下一代数据中心解决方案 以满足不断增长的带
- 新日本无线为IoT电子器件推出具有宽带、超低功耗的运
- ADI公司隔离式电源转换器支持B类系统EMI等级-embedcc
- PI现可提供已通过汽车级AEC-Q100认证的SCALE-iDriver
- 聚焦智慧视频,Socionext推出升级版混合编解码器-embe









