N2 Purge在LPCVD炉管氮化硅工艺中的应用 - 工艺设备 -
来源: 网络用户发布,如有版权联系网管删除 2018-09-20
在亚微米的生产制造技术中,氮化硅工艺的particle已经成为产品良率的主要影响因素。本文主要针对立式LPCVD氮化硅炉管的氮化硅制造工艺中所遇到particle问题进行研究。通过大量的对比性实验进行排查与分析,并利用各种先进的实验的设备和器材找到产生particle的原因,找到解决particle问题的方案。结果证明不仅延长了机台的维护周期,而且改善了机台的particle状况,最终获得良率的提升,优化了制造工艺。
LPCVD氮化硅工艺的Particle问题分析
LPCVD氮化硅制备工艺通常在中等真空程度下的反应腔体内通入反应气体二氯二氢硅(SiH2Cl2)和氨气(NH3)来生成氮化硅,反应温度一般为300-900度(图1)。
反应方程式:3SiH2Cl2+4NH3→Si3N4+6HCl+6H2
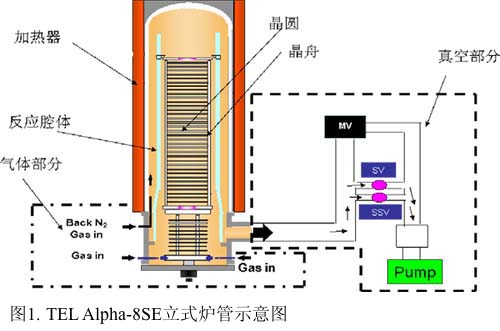
晶圆的particle分布图见图2,发现particle主要分布在晶圆的边缘部分。在SEM下分析这些particle(图3),可以很清楚的看到这些particle是一些薄膜的剥落,而利用EDX来分析的结果则显示这些particle的主要成分是氮元素和硅元素。

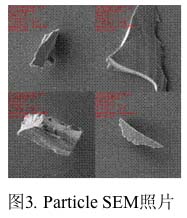
根据对particle的初步分析,认为这些particle的来源是在生产中剥落下来的氮化硅薄膜。那么是什么原因使沉积在反应腔上的薄膜剥落下来呢?
查看评论 回复









