先栅极还是后栅极 业界争论高K技术 - 资讯 -
先栅极还是后栅极 业界争论高K技术
随着晶体管尺寸的不断缩小,HKMG(high-k绝缘层+金属栅极)技术几乎已经成为45nm以下级别制程的必备技术.不过在制作HKMG结构晶体管的 工艺方面,业内却存在两大各自固执己见的不同阵营,分别是以IBM为代表的Gate-first(先栅极)工艺流派和以Intel为代表的Gate-last(后栅极)工艺流派,尽管两大阵营均自称只有自己的工艺才是最适合制作HKMG晶体管的技术,但一般来说使用Gate-first工艺实现HKMG结构的难点在于如何控制 PMOS管的Vt电压(门限电压);而Gate-last工艺的难点则在于工艺较复杂,芯片的管芯密度同等条件下要比Gate-first工艺低,需要设 计方积极配合修改电路设计才可以达到与Gate-first工艺相同的管芯密度级别。
本文引用地址: http://power.21ic.com//dc/infor/201007/22548.html
Gate-last阵营:目前已经表态支持Gate-last工艺的除了Intel公司之外(从45nm制程开始,Intel便一直在制作HKMG晶体管时使用Gate-last工艺),主要还有芯片代工业的最大巨头台积电,后者是最近才决定在今年推出的28nm HKMG制程产品中启用Gate-last工艺。
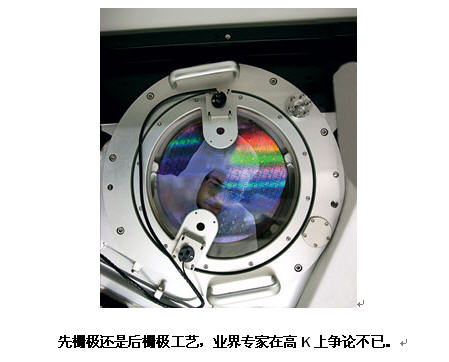
Gate-first阵营:Gate-first工艺方面,支持者主要是以IBM为首的芯片制造技术联盟 Fishkill Alliance的所属成员,包括IBM,英飞凌,NEC,GlobalFoundries, 三星,意法半导体以及东芝等公司,尽管该联盟目前还没有正式推出基于HKMG技术的芯片产品,但这些公司计划至少在32/28nm HKMG级别制程中会继续使用Gate-first工艺,不过最近有消息传来称联盟中的成员三星则已经在秘密研制Gate-last工艺(有关内容详见这个链接)。另外,台湾联电公司的HKMG工艺方案则较为特殊,在制作NMOS管的HKMG结构时,他们使用Gate-first工艺,而制作PMOS管时,他们则会使用Gate-last工艺。
不管使用Gate-first和Gate-last哪一种工艺,制造出的high-k绝缘层对提升晶体管的性能均有重大的意义。high-k技术不仅能够大幅减小栅极的漏电量,而且由于high-k绝缘层的等效氧化物厚度(EOT:equivalent oxide thickness)较薄,因此还能有效降低栅极电容。这样晶体管的关键尺寸便能得到进一步的缩小,而管子的驱动能力也能得到有效的改善。
不过,采用Gate-first工艺制作HKMG结构时却有一些难题需要解决。一些专家认为,如果采用Gate-first工艺制作HKMG,那么由于用来制作high-k绝缘层和制作金属栅极的材料必须经受漏源极退火工步的高温,因此会导致PMOS管Vt门限电压的上升,这样便影响了管子的性能。而持不同观点的专家,包括GlobalFoundries公司的技术总监John Pellerin等人则强调Gate-first工艺不需要电路设计方在电路设计上做太多更改,而且性能上也完全能够满足32/28nm节点制程的要求。
Pellerin 强调:“我们肯定会在28nm节点制程上使用Gate-first工艺。其原因是我们的客户希望在转换到HKMG结构时能够尽量避免过多的设计变更。”
台积电的技术高管蒋尚义则表示,类似的难题业界在20年前便曾经经历过:“当时业界同样曾经发现N+掺杂的PMOS栅极材料会造成Vt电压较高,这样业内一些公司便开始向沟道中掺杂杂质以压低Vt,结果却带来了很多副作用,比如造成短通道效应更为明显等等。”而目前使用Gate-first工艺制作HKMG晶体管的方案的情况则与此非常类似,尽管人们可以采用加入上覆层等方式来改善Gate-first工艺容易造成Vt过高的问题,但是加入上覆层的工艺却非常复杂和难于掌握。因此台积电干脆选择转向Gate-last工艺,不过Gate-last工艺实施时如果想保持与Gate-first工艺产品的管芯密度近似,需要设计方对电路Layout进行重新设计。
Gartner公司的半导体产业分析师Dean Freeman表示:“台积电转向Gate-last,说明这种工艺在性能方面还是存在一定的优越性的。虽然Gate-first工艺制成的产品在管芯密度方面 较有优势,但继续应用这种工艺一定存在一些台积电无法克服的难题。”
IMEC负责high-k技术研发的主管Thomas Hoffmann曾经在IEDM2009大会上指出了Gate-first工艺在性能方面存在的不足,不过在会后的一次访谈中,他表示尽管Gate- first存在一些性能方面的缺点,但是对一部分对性能并不十分敏感的第功耗器件还是能够满足要求的。
他表示:“对瑞萨等开发低功耗器件的公司而言,也许Gate-first工艺是目前较好的选择。这类器件一般对Vt值和管子的性能并没有太高的要求。不过当产品的制程节点发展到28nm以上级别时,这些公司便需要转向Gate-last。”
查看评论 回复