倒装晶片的组装焊接完成之后的检查 -
来源: 网络用户发布,如有版权联系网管删除 2018-08-05
[导读]焊接完成之后我们可以对产品进行一些非破坏性的检查,譬如,利用X射线检焊点是否桥连、开路,焊点内是 否有空洞,以及润湿情况,还可以进行电气测试。由于此时还未完成底部填充,不便进行机械测试和热循环及老 化测试
焊接完成之后我们可以对产品进行一些非破坏性的检查,譬如,利用X射线检焊点是否桥连、开路,焊点内是 否有空洞,以及润湿情况,还可以进行电气测试。由于此时还未完成底部填充,不便进行机械测试和热循环及老 化测试。
由于倒装晶片焊点在元件的下面,直接检查非常困难,利用X射线检查仪能够观察到一些焊接缺陷:
可以观察到焊接过程中倒装晶片具有非常好的“自对中性”,在氮气焊接环境中尤其突出。如图1和图2所示。


图1 焊接之前有―定偏移 图2 焊接之后元件被“拉正”
可以观察到焊接表面的润湿情况,如图3和图4所示。


图3 润湿及塌陷良好 图4 焊球与焊盘有偏移但润湿良好
可以观察到焊点焊接不完整,焊点开路,如图5所示。
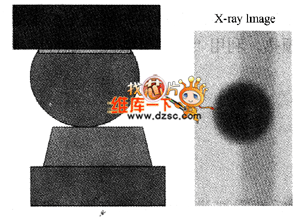
图5 焊点开路
还可以检查焊点内是否有空洞,如图6所示。

图6 焊点中的空洞
当然也可以对焊点进行切片检查其内部润湿和坍塌情况,以及量测元件离板高度,还可以结合金相显微镜或电 子扫描显微镜(SEM)检查焊点微结构,但这些检查建议在完成底部填充后进行,以免错失一些缺陷。如图7、图 8和图9所示。

图7 切片检查到焊点良好的润湿和坍塌


图8 润湿和坍塌不良 图9 润湿和坍塌不良
欢迎转载,信息来源维库电子市场网(www.dzsc.com)
来源:0次
查看评论 回复
"倒装晶片的组装焊接完成之后的检查 -"的相关文章
- 上一篇:芯片封装缩略语介绍 -
- 下一篇:带硬件地址识别的UART IP的设计和实现 -