平面全属化封装技术 -
来源: 网络用户发布,如有版权联系网管删除 2018-08-09
[导读]由于引线互连带来的种种问题,人们开始研究如何改进互连技术,以避免采用引线。1995年以后,陆续开发出了一些无引线的集成功率模块,其特点是:互连结构的电感小、散热好、封装牢固等。图1(a)、图1(b)、图1(c)
由于引线互连带来的种种问题,人们开始研究如何改进互连技术,以避免采用引线。1995年以后,陆续开发出了一些无引线的集成功率模块,其特点是:互连结构的电感小、散热好、封装牢固等。图1(a)、图1(b)、图1(c)分别给出了三种不同引线键合(Non-Wire Bond)的集成功率模块技术:(a)嵌人功率器件(CPES,1999),(b)层叠式器件PowerOverlay,(c)倒装芯片法(参考APEC⒛00)。嵌入功率器件的平面金属化封装技术是其中较好的一种。
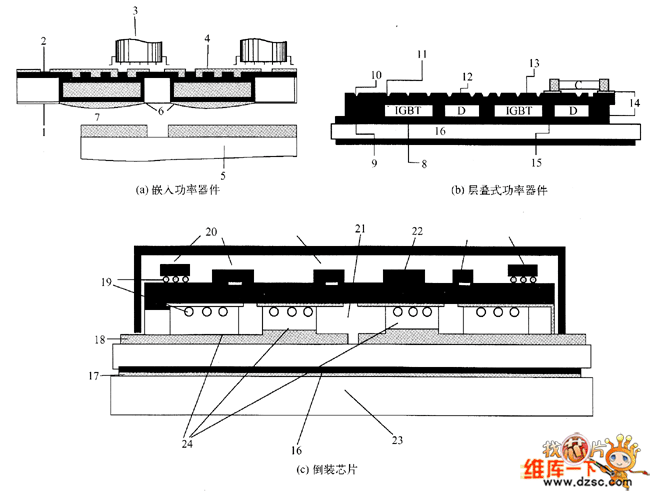
图1 不用引线键合的集成功率模块
图2给出了一个集成模块的剖面图,应用了嵌入功率器件的多层集成封装技术。包括:散热板、基板、绝缘传热材料、功率母线、功率器件、铜层、陶瓷、集成无源模块、金属层、表面贴装芯片(驱动、检测及保护元件)等。这种三维多层集成封装技术,将功率模块、集成电路等做成三明治(Sandwich)结构形式。
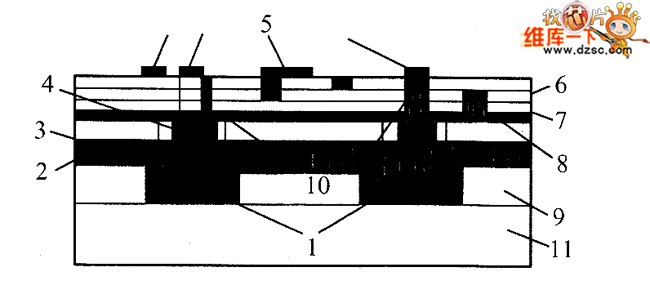
图2 嵌入功率器件的多层集成封装的剖面图
来源:0次
查看评论 回复